Aplicație: Scribing Dicing IC wafers, arsenidă de galiu, fosfură de galiu, placă de rășină epoxidică, cadru din aliaj, substrat ceramic, placă compozită cu inter -strat, etc.
Cum să selectăm tipurile corecte de lame de tăiere a wafer -ului pentru a tăia materialele?
* Liant de legătură de rășină (rezistență moale) Dicing Blade, scribing material dur și fragil
* Liant de legătură metalică (rezistență medie) Dicing Blade
* Liant de legătură electroplată (legătură dură), scribing material mai moale



Avantajele lamelor de ferăstrău cu butucul wafer
Tăierea cu precizie ridicată - asigură o abordare curată și precisă, cu o ciocnire minimă.
Rigiditatea superioară a lamei - reduce vibrațiile lamei pentru o stabilitate de tăiere îmbunătățită.
Proiectarea subțire a Kerf - minimizează pierderea materialelor și îmbunătățește randamentul.
Durata de viață extinsă - optimizată pentru durabilitate și performanță consistentă.
Specificații personalizabile - Disponibil în diferite grosimi, diametre și dimensiuni de granulație pentru a se potrivi cu aplicații specifice.
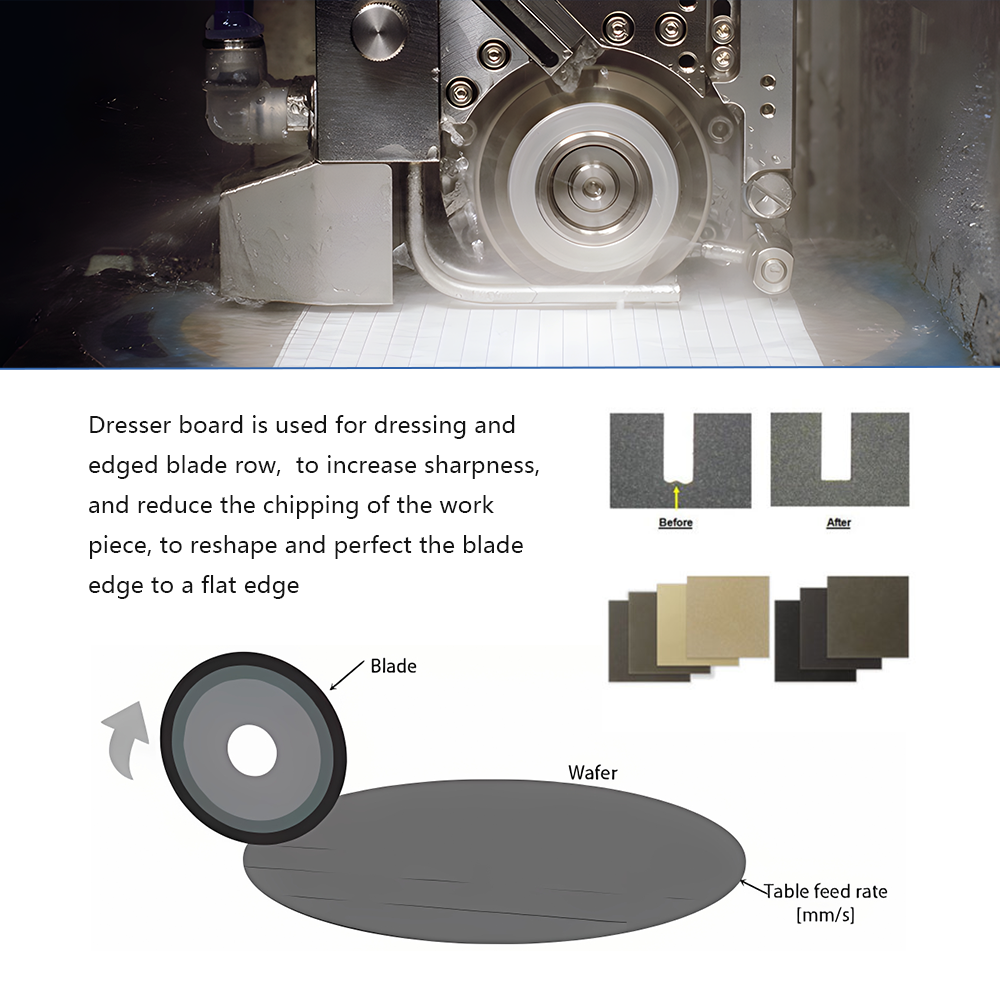
-

6a2 11a2 în formă de bol din rășină bond Diamond cbn grin ...
-

Roți de măcinare cu diamante metalice pentru carbid ...
-

1f1 roată de măcinare Diamond Diamond Diamond Diamond pentru C ...
-

Ascuțirea de diamante de legătură metalică de înaltă performanță ...
-

11v9 roată de măcinare cu diamante de rășină pentru volanul ...
-

Diamond de înaltă eficiență și metal CBN legat ...







